| |
|
  |
 Как побороть zombie shape? Как побороть zombie shape?, PCB Editor |
|
|
|
|
 Dec 17 2010, 10:59 Dec 17 2010, 10:59
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Вот откуда-то появился странный shape, который все время out-of-date и никак его не извести. Приложил пару картинок. Может, есть какой маневр?
Эскизы прикрепленных изображений
 РЈРСеньшено Р Т‘Р С• 68% 
543 x 534 (16.88 килобайт)
|
 РЈРСеньшено Р Т‘Р С• 84% 
1037 x 668 (94.97 килобайт)
|
|
|
|
|
|
|
|
|
 Dec 17 2010, 12:20 Dec 17 2010, 12:20
|
Частый гость
 
Группа: Свой
Сообщений: 178
Регистрация: 30-12-04
Из: Москва
Пользователь №: 1 762

|
Цитата(Uree @ Dec 17 2010, 17:33)  Совершенно не увидел там никакого шейпа. Так что смысл вопроса пока не ясен. А его и не будет видно, так как он динамический и поэтому не залит (что то c constraints) Для того, что увидеть очертания динамического полигона надо включишь слои в Stack-up -> boundary. После этого принимать решение либо удалить его, либо изменить constraints.
|
|
|
|
|
|
|
|
 Dec 17 2010, 12:33 Dec 17 2010, 12:33
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Ага, вот и я там никакого шейпа не вижу. И выделить даже не могу. А оно пишет, что он есть и out-of-date  Вот я и спрашиваю, можно ли как-то править редактору мозги? Что касается замечания, то это все страхи и предрассудки. Во-первых, индуктивность проводника практически не зависит от его толщины, зависит больше от длины, но длина определяется шагом BGA. Если посмотреть под микроскопом, какой толщины проводники на подложке BGA, то вопросы сами собой пропадут. Во вторых, в цепях питания важнее омическое сопротивление проводника. Так вот, для стандартной толщины меди 18 мкм есть удобное правило, что квадратик меди имеет сопротивление в 1 мОм. То есть, при токе в 1А (такой порядок тока ядра DSP у меня), такой проводник потянет на 1 мВ. Как видно из картинки между падом и КП отверстия как раз примерно квадратик и есть. И меня он не пугает. У меня в цепи измерения тока ядра 5 мОм стоит, а тут 50 точек параллельного подключения с сопротивлением в 1 мОм. Это просто ноль на практике. Из неуказанных Вами соображений могу еще привести одно. Более толстые цепи земли и питания теоретически дают лучший теплоотвод от кристалла в слои питания и земли, которые используют плату как радиатор. Но это хорошо и правильно, когда плата будет продуваться, так что поверхность платы действительно как радиатор будет работать. А в моем случае плата будет ставиться в герметичный корпус без внутренних вентиляторов. Так что тепло с платы само по себе никуда не утечет, его надо снимать прямо с корпусов микросхем на корпус прибора. Теперь наконец, приведу соображение, чем тонкие проводники лучше. Дело в том, что у площадок NSMD (non-soldermask defined) есть освобождение от маски, которое больше самой КП вывода и оголяет этот самый несчастный проводник. Да кусочек, да самый маленький кусочек. Но вот этот кусочек замечательно паяется и утягивает на себя часть припоя. И когда он толстый, то шарик сильно деформируется, а это ведет к тому, что в пайке возникают напряжения и пайка как механическое соединение становится хуже. Выше риск, что при вибрациях, изгибах платы и особенно термоциклах (у меня было такое на практике), такая пайка умрет. Но это уже дискуссия про технологию, а не про Cadence  Цитата Для того, что увидеть очертания динамического полигона надо включишь слои в Stack-up -> boundary. Да, он увиделся при включении Stack-Up -> Conductor -> Top -> Bound. И в итоге я его удалил. Спасибо!
|
|
|
|
|
|
|
|
 Dec 17 2010, 13:49 Dec 17 2010, 13:49
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Выглядит так, что трудно вообще разобраться, где кончается BGA  Я тоже делал толстые проводники питания, правда не заливал их в слое TOP. Но потом поглядел, что у чипа снизу, и обиделся на всех этих доброхотов. Приложил две иллюстрации, снятые с камеры. Оба чипа с шагом 0.8 мм. Первая картинка - это вид на стандартную память DDR2 SDRAM. Втрорая - DSP, правда по нынешним временам уже старичок. Вот теперь вопрос, сколько квадратиков уложится в разводке на стороне BGA.
Эскизы прикрепленных изображений
 РЈРСеньшено Р Т‘Р С• 87% 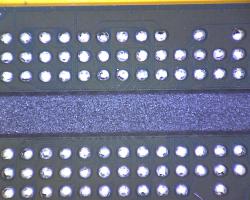
1280 x 1024 (228.38 килобайт)
|
 РЈРСеньшено Р Т‘Р С• 87% 
1280 x 1024 (196.45 килобайт)
|
|
|
|
|
|
|
|
|
 Dec 17 2010, 14:08 Dec 17 2010, 14:08
|
Знающий
     
Группа: Свой
Сообщений: 5 223
Регистрация: 25-04-05
Из: Z. Gora
Пользователь №: 4 480

|
Это только кусок BGA, на этом скрине. Края не влезли.
А по поводу этих фоток, на памяти очень хороший пример - обратите внимание какими красивыми плэйнами залито все, кроме сигналов. Опять же не забываем, что там все это кучей микроВИА уходит на верх, к распайке собственно кристалла.
Да, если вернуться к индуктивности, то получается такая штука - увеличение ширины трассы с 5 до 15 милсов(что при диаметре пада 20 милсов очень даже возможно) уменьшает погонную индуктивность в два раза. Ну а основы теории цепей помним - ток в индуктивности не может меняться скачком. Чем меньше индуктивность, тем быстрее происходит нарастание этого тока. Грубо говоря захочет ДСП по быстрому "скушать" больше тока, а узкие дорожки ему скажут "подожди", "попозже". В итоге провал напряжения на пинах питания, провал напряжения на драйверах, завал фронтов сигналов - приплыли... не вписываемся в заданные параметры. У нас на SATA была такая ситуация, больше повторять не хочется.
Хотя Вам решать, что и как Вы делаете.
|
|
|
|
|
|
|
|
 Dec 17 2010, 14:24 Dec 17 2010, 14:24
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Похоже на какой-то чипсет от интела, у которого куча рядов, да еще и сдвинутые подмножества шариков. Вот на второй фотке, где DSP, видны контактные площадки микровиа, и видно что к ней идет приличных размеров сопля. Не забываем также про распайку кристалла, длина тех проволочек заметно больше, чем проводничок от отверстия до КП вывода на футпринте. Так что индуктивностью перемычек BGA, по-моему, можно пренебречь, особенно в цепях питания. Завал фронтов, кстати, может быть от избыточной емкости входной цепи, если все вокруг шейпами залить 
|
|
|
|
|
|
|
|
 Dec 18 2010, 08:37 Dec 18 2010, 08:37
|

Частый гость
 
Группа: Свой
Сообщений: 80
Регистрация: 21-03-05
Пользователь №: 3 559

|
Цитата(Uree @ Dec 17 2010, 19:41)  Тем более реально никаких противопоказаний делать питания как можно "грубее" нет. Вообще-то есть  http://focus.ti.com/lit/an/spraav1b/spraav1b.pdf http://focus.ti.com/lit/an/spraav1b/spraav1b.pdfpage 10-11, 23-24 "the trace width exiting the BGA pad is much too large. In this case the trace acts as a heatsink during reflow" Я не сторонник тонких проводников питания - совсем наоборот  . Но надо знать меру.
|
|
|
|
|
|
|
|
 Dec 18 2010, 11:02 Dec 18 2010, 11:02
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Цитата А как Вам например земля/питания под BGA в виде шейпов? Вот еще какая мысль есть. Прикрепил пару PDF от TI, в которых расписано, как делать BGA площадки. Вот если внимательно посмотреть на таблички и картинки там, то видно, что TI рекомендует для площадок NSMD делать освобождение от маски на 0.15 мм больше, чем размер КП. Причем эти 0.15 мм - это около 25% сверху номинального диаметра площадки. А площадь будет и того в полтора раза больше. Так вот, когда Вы заливаете группу BGA контактов шейпами, то фактически получаете SMD площадки, причем совершенно несбалансированные с площадками на чипе. А это плохо, об этом написано в разделе 3.2.1 первого документа и в разделе с таким же названием второго. Еще видно из картинки, что питание ядра чипа вперемежку с землей дало изрезанный шейп. То есть, связность его все равно во внутреннем слое достигается, а наверху только площадки все раздвинулись. Имхо лучше сразу перейти на SMD (SolderMask Defined) pads), тогда заливка не будет мешать. Но я как-то попробовал с одним интеловским PHY'ем, и получил подставу от производства. Там люди не привыкли к этому, у них принято подгонять маску под свои нормы автоматически, и они мне в итоге сделали площадки 0.6, с маской 0.7, вместо площадок 0.6 с маской 0.45. Поскольку проект делался, как обычно делаются у нас проекты на бюджетные деньги, когда надо было вчера, технологам дали понять, что "Вася, ты неправ", но переделывать было уже просто некогда, образец был опытный, собрался и заработал и так. Но правда, сейчас умирает он периодически и приходится его перепаивать. Правда, испытания на климатику и тряску он прошел, как ни странно. После этого полежал на полке в грязи у заказчика и прокис  Цитата Автор упоминал, что не будет вентиляторов и говорил, что поэтому, типа, такой теплоотвод не эффективен. Можно поспорить: если вывести полигоны куда-нибудь в спец. зону теплоотвода, то можно улучшить охлаждение. Обычно все военные конструктивы по боками имеют такие зоны, куда при сборке крепятся радиаторы/клинья. Вот не надо обобщать, не все!  Так делают, когда конструкция состоит из кроссплаты и врубных плат (например, CompactPCI). Так как платы съемные, а обдува нет, то их пытаются охлаждать через направляющие. Бывает и иначе, внутренний обдув в герметичном корпусе прокачивает воздух через полые стенки корпуса. Видел я такую конструкцию. Дорого и неэффективно. Поэтому у нас проще. Простой мезонин в виде SoM, но все чипы с него просто через heat spreader прямо к корпусу и прижимаются. Плюс еще сами чипы с запасом хорошим. Процессор вот, например, сам по себе до +105C может работать. Ему и теплоотвод почти не нужен. Но для +70С окружающей среды пусть будет.
Сообщение отредактировал Hoodwin - Dec 18 2010, 11:16
|
|
|
|
|
|
|
|
 Dec 18 2010, 16:55 Dec 18 2010, 16:55
|
Знающий
   
Группа: Участник
Сообщений: 881
Регистрация: 21-03-10
Из: _// \\_
Пользователь №: 56 107

|
Цитата Если вы паяете феном, то безусловно руками можете корпус подвигать, и проблем нет. Но в печи, где некому двигать, некоторые шарики не припаиваются, или получается холодная пайка, что еще хуже. Фен никогда с печкой не сравнится. Я сам феном никогда не паял, но паял PACE'овской ThermoFlo, которая имеет программируемые профили пайки. Штук 100 однотипных корпусов поставил и многие потом переставил, так что уже много навидался. Во-первых, в печке прогревается вся плата, и она уже не отсасывает тепло. Во-вторых, в печку плата попадает с паяльной пастой, нанесенной на площадки BGA, в третьих, сам чип там поставлен точнее. Когда на площадках есть паста, то она активирует площадки, делает их смачиваемыми, а главное, появляется капелька припоя на площадке, которая гарантирует захват шарика. При ручной установке, когда вместо пасты все просто мажется флюсом, часто бывает так, что шарик плавится, но он меньше чуть, чем остальные, и ему не продавить флюс до площадки (золотой). Мне часто приходилось наблюдать мелкие отказы отдельных шариков, хотя в печке они паялись на этих платах со 100% результатом.
Сообщение отредактировал Hoodwin - Dec 18 2010, 17:46
|
|
|
|
|
|
|
  |
1 чел. читают эту тему (гостей: 1, скрытых пользователей: 0)
Пользователей: 0

|
|
|