| |
 фиксация корпуса BGA перед пайкой фиксация корпуса BGA перед пайкой, как это делается на mass production? |
|
|
|
 |
Ответов
|
|
 May 25 2018, 13:49 May 25 2018, 13:49
|

Знающий
   
Группа: Свой
Сообщений: 825
Регистрация: 28-11-07
Из: г.Винница, Украина
Пользователь №: 32 762

|
Цитата(Димыч @ May 24 2018, 16:29)  На знакомом предприятии - как они взялись паять BGA на пасту, 30% брака из-за закороток пот чипом, хотя термопрофиль соблюдается, флюсы какие надо и т.д. - неправильно спроектированы пады, - завышенные апертуры в трафарете, - избыточная толщина трафарета, - ошибки установки корпуса на плату (смещение, усилие), - размазывание пасты при снятии трафарета, - неправильно подобрана паста/ракель... Причин может быть много, и не одна. Нужно смотреть на на все (весь техпроцесс) в комплексе. BGA паяются уже давно и успешно. Закоротки под чипами - это не от того что чип такой (простой, на самом деле), а от несоблюдения технологии монтажа и/или технолгии проектирования платы.
--------------------
Тезис первый: Не ошибается лишь тот, кто ничего не делает.
Тезис второй: Опыт - великое дело, его не пропьёшь :).
|
|
|
|
|
|
|
|
 May 25 2018, 18:06 May 25 2018, 18:06
|

Знающий
   
Группа: Свой
Сообщений: 825
Регистрация: 28-11-07
Из: г.Винница, Украина
Пользователь №: 32 762

|
Цитата(Lmx2315 @ May 25 2018, 18:32)  Было бы любопытно - если кто прокомментирует. И я когда то прототипы похожим образом паял - на флюс-гель. Это допустимо, если нужно побыстрому запустить плату. Цитата(ZZmey @ May 25 2018, 18:39)  В серии не вариант. Не технологично, прежде всего. И с надежностью после пайки есть определенные проблемы.
--------------------
Тезис первый: Не ошибается лишь тот, кто ничего не делает.
Тезис второй: Опыт - великое дело, его не пропьёшь :).
|
|
|
|
|
|
|
|
 May 25 2018, 18:26 May 25 2018, 18:26
|
Профессионал
    
Группа: Свой
Сообщений: 1 687
Регистрация: 11-01-05
Из: Москва
Пользователь №: 1 884

|
Цитата(bigor @ May 25 2018, 16:49)  - неправильно спроектированы пады,
- завышенные апертуры в трафарете,
- избыточная толщина трафарета,
- ошибки установки корпуса на плату (смещение, усилие),
- размазывание пасты при снятии трафарета,
- неправильно подобрана паста/ракель...
Причин может быть много, и не одна.
Нужно смотреть на на все (весь техпроцесс) в комплексе.
BGA паяются уже давно и успешно. Закоротки под чипами - это не от того что чип такой (простой, на самом деле), а от несоблюдения технологии монтажа и/или технолгии проектирования платы.  Цитата(bigor @ May 25 2018, 21:06)  И с надежностью после пайки есть определенные проблемы. Нельзя ли поподробнее ?
--------------------
Если хочешь узнать, что ждет тебя на дороге впереди, спроси у тех, кто возвращается по ней.
|
|
|
|
|
|
|
|
 Jun 1 2018, 08:52 Jun 1 2018, 08:52
|

Знающий
   
Группа: Свой
Сообщений: 825
Регистрация: 28-11-07
Из: г.Винница, Украина
Пользователь №: 32 762

|
Цитата(a123-flex @ May 25 2018, 21:26)  Нельзя ли поподробнее ? Можно. Но в рамках форума - это сделать трудно. Все же по этой теме куча народу когдато сочинило множетво литературы... В двух словах - при монтаже BGA на пасту паяные соединения имеют ярковыраженную бочкообразную форму
При монтаже без пасты - "бочка" приплюснута или вообще вырождена
Разница в том, что в первом варианте, при остывании на заключительном этапе оплавления, сначала "прихватываются" области припоя возле падов (на плате и на подложке, поскольку корпуса и плата остывают чуть быстрее чем сами шары), а делее процесс перехода расплава в тывердую фазу идет к центру бочки. Все примеси, которые есть в паяном соединении, а главное, воидсы смещаются вдоль границы тверда-жидкая среда (зонный эффект) также к центру. Таким образом самые уязвимые места - область контакта пада (на плате и на подложке) с припоем остаются чистыми, без трещинок, воидсов и загрязнений. Примеси в этой области являются причиной растрескивания паяных соединений в прецессе эксплуатации при термоциклировании, поскольку эти области неоднородны изначально. Во втором случае, особенно при вырожденной "бочке" вероятность трещин и воидсов в области контакта весьма высока. 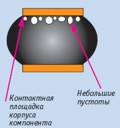 Это приводит к возникновению спорадических отказов, которые тяжело отследить. 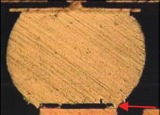 Второе - пайка без пасты может породить проблему несмачиваемости, особенно если профиль пайки и флюс не "дружат" - флюс выкипел раньше начала оплавления шара, что весьма часто встречается при безсвинцовых шарах.  Третье - разброс (технологический) при нанесении шаров, порождает проблему, когда несколько шаров (особенно близко к краю подложки при большом размере корпуса) просто не касаются платы. Приблизительно так
Ведь подложка BGA деформируется при нагревании - ее края немного приподымаются по отношению к центральной части. Работает эффект разных ТКЛР для материала подложки и для материала компаунда, которым кристал залит.
--------------------
Тезис первый: Не ошибается лишь тот, кто ничего не делает.
Тезис второй: Опыт - великое дело, его не пропьёшь :).
|
|
|
|
|
|
Сообщений в этой теме
 Димыч фиксация корпуса BGA перед пайкой May 24 2018, 08:17 Димыч фиксация корпуса BGA перед пайкой May 24 2018, 08:17  Corvus Цитата(Димыч @ May 24 2018, 11:17) Но под... May 24 2018, 08:21 Corvus Цитата(Димыч @ May 24 2018, 11:17) Но под... May 24 2018, 08:21  Uree Не знаю, с чего вдруг "по уму" стало нел... May 24 2018, 09:06 Uree Не знаю, с чего вдруг "по уму" стало нел... May 24 2018, 09:06  Aner Наносится паста всегда через трафарет по стандарту... May 24 2018, 09:44 Aner Наносится паста всегда через трафарет по стандарту... May 24 2018, 09:44   Aner QUOTE (Димыч @ May 24 2018, 16:29) Ok, сп... May 24 2018, 15:35 Aner QUOTE (Димыч @ May 24 2018, 16:29) Ok, сп... May 24 2018, 15:35     Flood Цитата(Lmx2315 @ May 25 2018, 18:32) Было... May 25 2018, 18:38 Flood Цитата(Lmx2315 @ May 25 2018, 18:32) Было... May 25 2018, 18:38      ZZmey Цитата(Flood @ May 25 2018, 21:38) Это ре... May 25 2018, 19:01 ZZmey Цитата(Flood @ May 25 2018, 21:38) Это ре... May 25 2018, 19:01  ZZmey Ставят на демо-плату из набора для отработки навык... May 25 2018, 15:39 ZZmey Ставят на демо-плату из набора для отработки навык... May 25 2018, 15:39  Димыч Aner, bigor,
Большое спасибо за комментарии и соо... May 27 2018, 04:28 Димыч Aner, bigor,
Большое спасибо за комментарии и соо... May 27 2018, 04:28
1 чел. читают эту тему (гостей: 1, скрытых пользователей: 0)
Пользователей: 0

|
|
|